一、 载流子的漂移运动和迁移率
1. 导体的欧姆定律
- 电流密度 $J$:通过垂直于电流方向单位面积的电流,单位 A/cm²
- 欧姆定律微分形式:
$$J = \sigma E = \frac{E}{\rho}$$
其中 $\rho$ 为电阻率(Ω·cm),$\sigma$ 为电导率(S/cm)
2. 漂移速度与迁移率
漂移运动:外加电场后,载流子受电场力作用沿电场方向(电子反向)作定向运动。
平均漂移速度 $\bar{v}_d$:定向运动的平均速度。
电流密度与漂移速度的关系:
$$J = nq\bar{v}_d$$
迁移率 $\mu$(单位:cm²/V·s):
$$\mu = \frac{\bar{v}_d}{E}$$
物理意义:单位场强下载流子的平均漂移速度,描述载流子在电场下移动的难易程度。迁移率越大,载流子越容易在电场中运动。
3. 半导体的电导率与迁移率
半导体中,导带电子和价带空穴均参与导电。两者运动方向相反,但贡献电流方向相同。
漂移电流密度:
$$J_n = nq\mu_n E \quad \text{(电子)}$$
$$J_p = pq\mu_p E \quad \text{(空穴)}$$
总电流密度:
$$J = (nq\mu_n + pq\mu_p)E$$
半导体电导率:
$$\sigma = nq\mu_n + pq\mu_p$$
| 类型 | 主导载流子 |
|---|---|
| n型半导体 | 电子($\mu_n$ 大) |
| p型半导体 | 空穴($\mu_p$ 大) |
| 本征半导体 | 电子和空穴均参与 |
外加电场后能带的变化:平衡态能带水平;加电场后能带倾斜,倾斜幅度等于 $qV$($V$ 为外加电压),电子向高能端运动,空穴向低能端运动。
加电场前后能带的变化
二、载流子的散射
1. 散射的概念与欧姆定律的定性解释
问题:若电子只受电场力匀加速,速度应无限增大,但实验中电流恒定——矛盾!
散射的本质:载流子在热运动中与晶格原子、电离杂质发生碰撞,导致速度大小和方向改变。
重要概念:
- 平均自由程:连续两次散射间自由运动的平均路程
- 平均自由时间 $\tau$:连续两次散射间自由运动的平均时间
欧姆定律的定性解释:
- 无电场:载流子热运动无规则,宏观净电流为零
- 有电场:电场给载流子附加定向速度;散射使附加速度重新随机化,不能无限积累 → 形成恒定的平均漂移速度 → 恒定电流
2. 主要散射机构
主要散射机构轨迹对比
(1)电离杂质散射
电离施主(正电荷)和电离受主(负电荷)产生库仑场,局部破坏晶格周期性势场,使经过附近的载流子偏转(类似 α 粒子在库仑场中的双曲线轨迹)。
散射几率 $P_i$:
$$P_i \propto \frac{N_i}{T^{3/2}}$$
说明:$N_i$(杂质浓度)越高,散射越强;$T$ 越高,载流子热速度越大,掠过杂质时偏转越小,散射几率反而减小。
(2)晶格振动散射(声子散射)
晶格振动分为两类:
- 声学波:原胞内原子同向振动,频率低,代表质心运动 → 硅、锗的主要散射机制
- 光学波:原胞内原子反向振动,频率高,质心不动 → 在离子性半导体(如 GaAs)中重要
晶格振动能量量子化为声子,散射等效为载流子与声子的碰撞(遵从准动量守恒和能量守恒)。
声学波散射几率 $P_A \propto T$,光学波散射几率 $P_O$ 随温度升高而升高。
(3)其他散射机构
| 散射类型 | 物理机制 | 起作用条件 |
|---|---|---|
| 等同能谷间散射 | 电子从一个极值跃迁到另一个(Si的6个等能谷) | 温度较高 |
| 中性杂质散射 | 未电离杂质对周期势的微扰 | 低温、重掺杂 |
| 位错散射 | 位错线俘获电子形成负电中心,产生附加电场 | 晶体质量差 |
| 载流子间散射 | 载流子相互碰撞 | 强简并半导体 |
三、迁移率与杂质浓度和温度的关系
1. 平均自由时间与散射几率的关系
设 $t=0$ 时有 $N_0$ 个电子开始运动,$N(t)$ 为 $t$ 时刻未被散射的电子数,则:
$$\tau = \frac{1}{P} \quad \text{(平均自由时间 = 散射几率的倒数)}$$
2. 迁移率与平均自由时间的关系
在 $x$ 方向加电场,对电子进行统计平均,得平均漂移速度:
$$\bar{v}_d = \frac{q\tau}{m^*} E$$
因此:
$$\mu = \frac{q\tau}{m^*}$$
- 电子迁移率:$\mu_n = \dfrac{q\tau_n}{m_n^*}$
- 空穴迁移率:$\mu_p = \dfrac{q\tau_p}{m_p^*}$
结论:$\tau$ 越大(散射越弱),$m^*$ 越小,迁移率越大。
电导有效质量(以Si为例):Si导带有6个旋转椭球形等能面,横向有效质量 $m_t = 0.19 m_0$,纵向 $m_l = 0.98 m_0$,电导有效质量:
$$\frac{1}{m_c} = \frac{1}{3}\left(\frac{1}{m_l} + \frac{2}{m_t}\right) \Rightarrow m_c = 0.26 m_0$$
3. 多种散射机构共存时的迁移率
迁移率随温度及散射机构的变化规律
总散射几率为各机构之和:
$$P = P_1 + P_2 + \cdots$$
总迁移率(Matthiessen 规则):
$$\frac{1}{\mu} = \frac{1}{\mu_1} + \frac{1}{\mu_2} + \cdots$$
物理含义:迁移率由散射最强($\tau$ 最小)的机构决定。
各散射机构对迁移率的温度依赖性:
| 散射机构 | $\mu$ 与 $T$ 的关系 |
|---|---|
| 声学波散射 | $\mu \propto T^{-3/2}$(T升高,散射增强,μ减小) |
| 电离杂质散射 | $\mu \propto T^{3/2}/N_i$(T升高,载流子速度快,μ增大) |
| 光学波散射 | 低温不起作用,高温才显著 |
4. 迁移率与掺杂浓度、温度的综合规律
迁移率与杂质浓度的关系
温度变化,不同浓度下的行为:
- 低掺杂($N_i = 10^{13} \sim 10^{17}$ cm⁻³):以声学波散射为主,$T$ 升高 → $\mu$ 下降
- 中掺杂($N_i \sim 10^{18}$ cm⁻³):两者共同作用,$\mu$ 下降趋势减缓
- 高掺杂($N_i \sim 10^{19}$ cm⁻³):低温以电离杂质散射为主,$\mu$ 先升(T升高时杂质散射减弱)再降(晶格散射主导)
杂质浓度升高,$\mu$ 单调下降(300K)
补偿半导体:载流子浓度由 $|N_D - N_A|$ 决定,但迁移率由 $N_D + N_A$ 决定(总电离杂质浓度)。
少子与多子迁移率(以 Si 为例):
- 低掺杂时,少子和多子的迁移率趋近相同(电子 ~1330 cm²/V·s,空穴 ~495 cm²/V·s)
- 掺杂浓度升高,少子和多子迁移率均下降,但少子迁移率高于多子迁移率(因为多子所处背景中电离杂质浓度更高)
四、电阻率及其与杂质浓度和温度的关系
1. 电阻率公式
$$\rho = \frac{1}{\sigma} = \frac{1}{q(n\mu_n + p\mu_p)}$$
- 本征硅(300K):$\rho \approx 2.3 \times 10^5\ \Omega\cdot\text{cm}$
- 本征锗(300K):$\rho \approx 47\ \Omega\cdot\text{cm}$
2. 电阻率与杂质浓度的关系(300K)
- 轻掺杂($N_i = 10^{16} \sim 10^{18}$ cm⁻³):室温下杂质全部电离,$\mu$ 随 $N_i$ 变化不大,杂质浓度升高 → 载流子增多 → $\rho$ 近似与 $N_i$ 成反比
- 重掺杂($N_i > 10^{19}$ cm⁻³):① 杂质不能全部电离;② $\mu$ 随 $N_i$ 升高而显著下降 → $\rho$ 偏离简单线性规律
3. 电阻率随温度的变化
掺杂半导体电阻率随温度的变化
本征半导体:$T$ 升高 → $n_i$ 指数增大(主控)→ $\rho$ 减小,负温度系数(NTC)
掺杂半导体(以 n 型为例,分三段):
ρ
| B──────C
| / \
| A D
└─────────────────── T| 温区 | 物理机制 | ρ 变化 |
|---|---|---|
| AB段(低温) | 杂质未全部电离,$T$↑ → 载流子增多 + 电离杂质散射减弱,$\mu$↑ | $\rho$ 减小 |
| BC段(中温,杂质饱和区) | 杂质全部电离,载流子浓度不变;$T$↑ → 晶格散射增强,$\mu$↓ | $\rho$ 增大 |
| CD段(高温,本征激发) | 本征激发主导,载流子浓度快速增大,远超 $\mu$ 下降的影响 | $\rho$ 减小 |
应用意义:BC 段类似于金属的正温度系数特性;半导体器件工作温区应避开 CD 段(本征激发导致失控)。
五、强电场下的效应——热载流子
漂移速度与电场强度的关系
1. 欧姆定律的偏离
- 弱场($E < 10^3$ V/cm):$\bar{v}_d \propto E$,$\mu$ 为常数,满足欧姆定律
- 强场($E > 10^3$ V/cm):$J$ 与 $E$ 不成正比,$\mu$ 不再是常数(载流子浓度基本不变,是 $\mu$ 发生变化)
- 饱和漂移速度:$E$ 很强时,$\bar{v}_d$ 趋于饱和值 $v_{sat}$(Si:~$10^7$ cm/s;Ge:~$5 \times 10^6$ cm/s),继续增大电场只是加热晶格,不再增加漂移速度
2. 热载流子
能量交换过程:
| 电场强度 | 载流子行为 |
|---|---|
| 无电场 | 与晶格热平衡,吸收声子 = 发射声子 |
| 弱电场 | 从电场获取少量能量,通过发射声子传给晶格 |
| 强电场 | 从电场获取大量能量,载流子平均能量 > 晶格能量 |
热载流子:强场下载流子平均能量远高于晶格热能,引入等效温度 $T_e > T$(晶格温度)来描述。
迁移率降低的解释:
$$\mu \propto \tau \propto T_e^{-3/2}$$
$T_e$ 升高 → 等效于更高温度 → $\mu$ 减小 → $\bar{v}_d$ 趋向饱和
六、多能谷散射与耿氏效应
GaAs中电子漂移速度与电场关系
1. GaAs 能带结构
GaAs 导带有两个重要极值(双能谷模型):
| 能谷 | 位置 | 有效质量 | 迁移率 |
|---|---|---|---|
| 能谷1(主谷) | 布里渊区中心 $\Gamma$ 点 | $0.067 m_0$ | $\mu_1 \approx 6000 \sim 8000$ cm²/V·s |
| 能谷2(卫星谷) | [111] 方向边界 $L$ 点 | $0.55 m_0$,比主谷高 0.29 eV | $\mu_2 \approx 920$ cm²/V·s |
2. 负微分迁移率(NDM)
平均迁移率:
$$\bar{\mu} = \frac{n_1\mu_1 + n_2\mu_2}{n_1 + n_2}$$
弱场下,电子全在能谷1,$\bar{\mu} = \mu_1$,迁移率高;
当 $E > E_T = 3.2 \times 10^3$ V/cm(阈值电场)时,能谷1的电子获得足够能量跃迁到能谷2($m^*$ 大、$\mu$ 小)→ $\bar{\mu}$ 下降 → 出现负微分电导/负微分迁移率
注意:这与热载流子机制不同,这里是载流子在 $k$ 空间发生了能谷间的重新分布。
耿氏效应中高场畴的形成
3. 高场畴与耿氏振荡
耿氏效应(1963年发现):n-GaAs 两端加 $E > 3000$ V/cm 时,电流发生 GHz 量级的周期性振荡(0.47 ~ 6.5 GHz)。
高场畴的形成与传播机制:
- 材料局部存在掺杂不均匀区 A,A 处电阻高 → 电场大 → 进入负微分电导区
- A 外电场小,载流子漂移速度快;A 内电场大,但因负微分电导,漂移速度反而慢
- 电子在 A 面向阳极一侧耗尽(正电荷),面向阴极一侧积累(负电荷)→ 形成空间电荷偶极层(偶极畴)
- 偶极畴内部电场与外场同向,畴内电场进一步升高(高场畴),畴外电场降低
- 偶极畴在达到稳态后以恒定速度 $v_d$ 向阳极漂移,到达阳极后消失
- 畴消失 → 体内电场恢复 → 新畴在阴极附近重新形成 → 周而复始 → 电流周期性振荡
振荡频率:$f = v_d / L$($L$ 为样品长度)
应用:GaAs 耿氏器件(转移电子器件)广泛用于微波振荡器;其他可产生振荡的材料有 n-InP、CdTe、InAs、n-Ge 等。
章节总结框图
载流子输运
│
├── 漂移运动 → μ = qτ/m* → σ = q(nμn + pμp)
│
├── 散射机构
│ ├── 电离杂质散射:Pi ∝ Ni/T^(3/2) → μi ∝ T^(3/2)/Ni
│ └── 晶格振动散射:PA ∝ T → μA ∝ T^(-3/2)
│
├── 电阻率 ρ = 1/σ
│ ├── 与Ni的关系:Ni↑ → ρ↓(轻掺杂)
│ └── 与T的关系:三段式(低温↓,中温↑,高温↓)
│
└── 强场效应
├── 热载流子:Te > T → μ下降 → vd饱和
└── 多能谷散射(GaAs):谷间转移 → 负微分电导 → 耿氏振荡

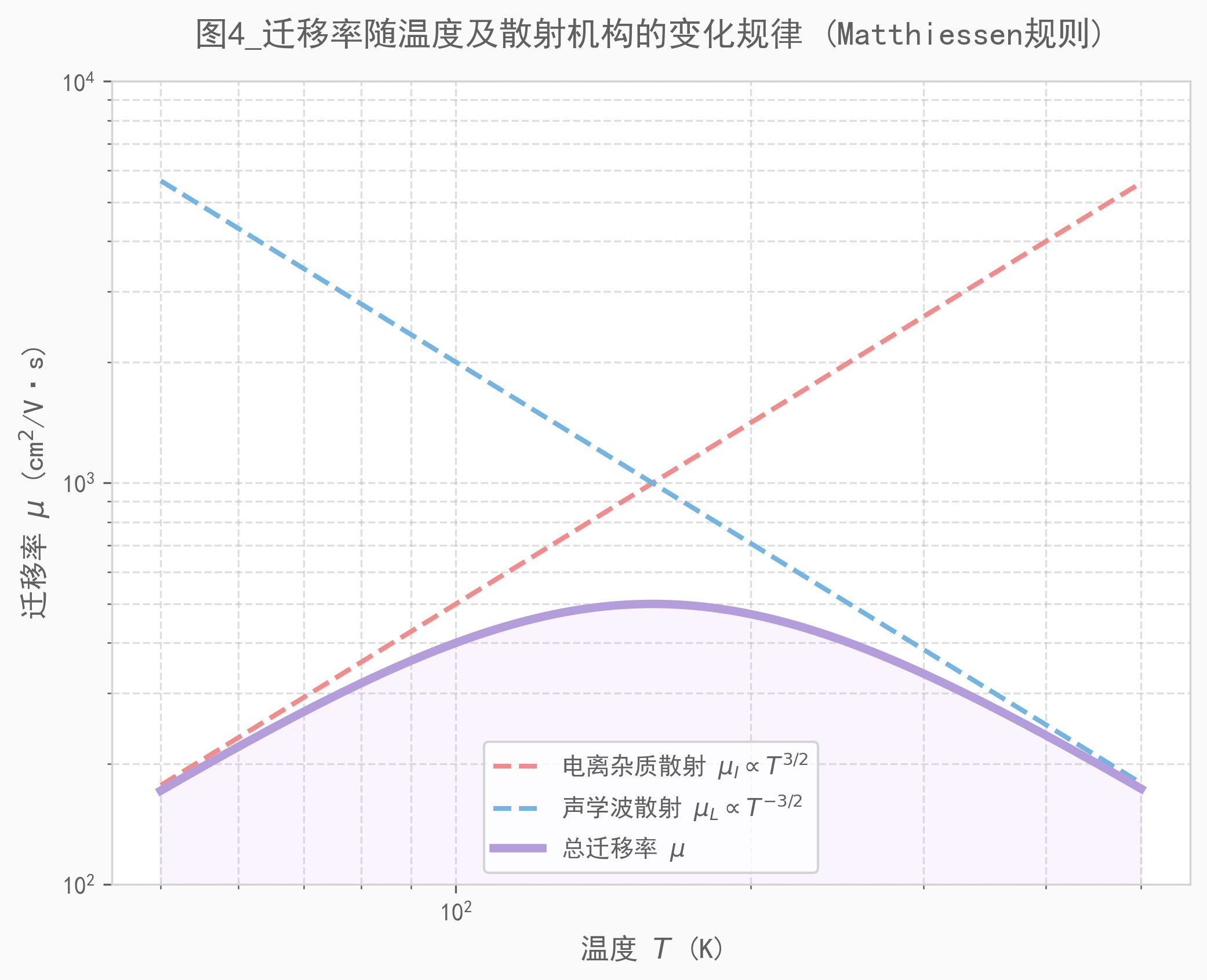



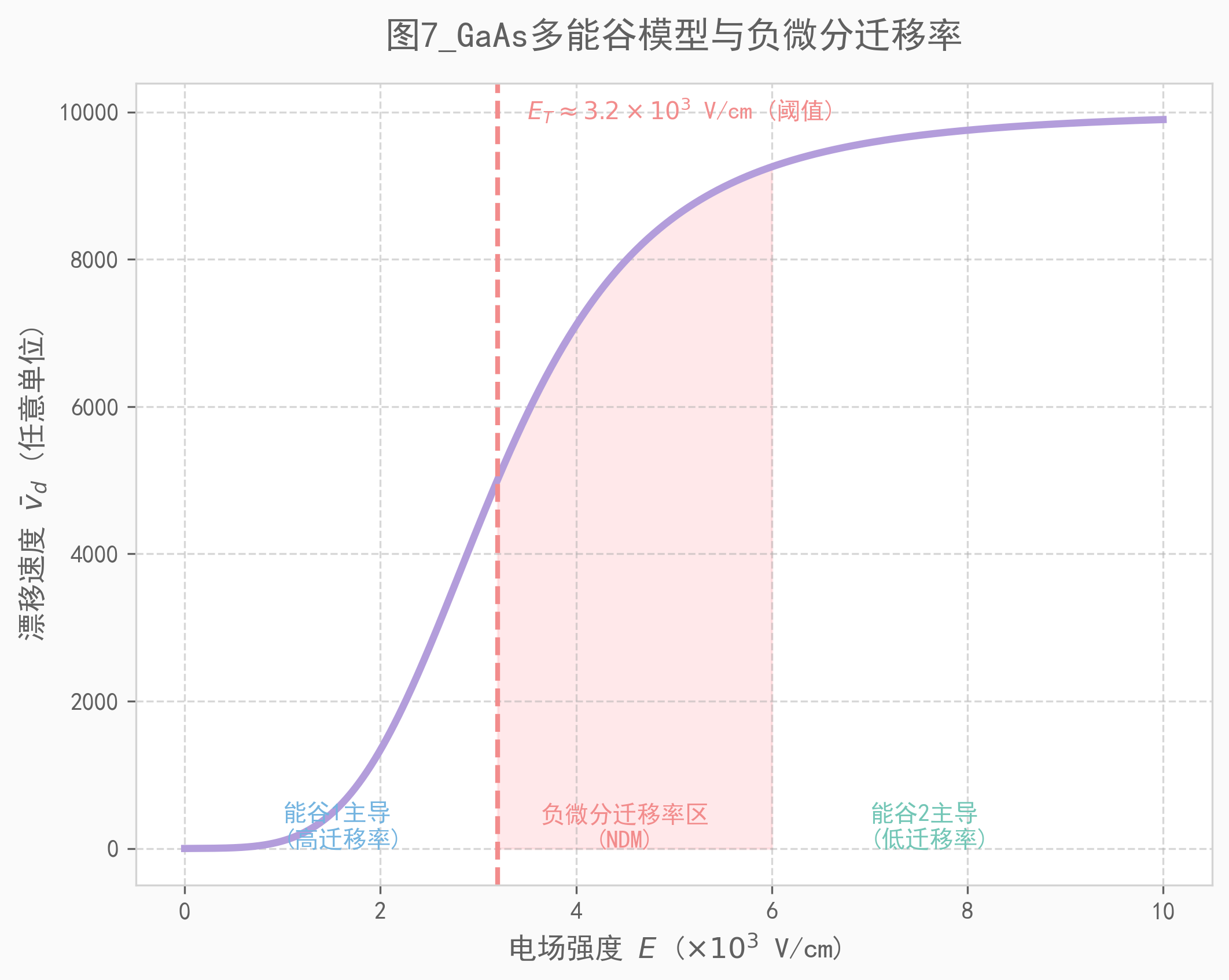

小纸条
这里没有小纸条