状态密度
能量状态密度的定义
定义: 在能带中,能量 $E$ 附近单位能量间隔内、单位体积半导体中所允许的量子态数,记作 $g(E)$。
物理意义: 描述量子态按能量分布的密集程度。它是能量的连续函数,决定了能带中特定能量水平上“能容纳电子的位置数目”。
状态密度的推导过程
状态密度的推导需要从动量空间(k空间)的量子态分布出发,并结合能带结构的 $E(\mathbf{k})$ 关系。
1. k 空间量子态分布
根据量子力学的周期性边界条件,晶体中电子的波矢 $\mathbf{k}$ 不能连续取值,而是分立的。对于体积为 $V = L^3$ 的立方体晶体:
- 允许的波矢分量为:$k_x = n_x\frac{2\pi}{L}, k_y = n_y\frac{2\pi}{L}, k_z = n_z\frac{2\pi}{L}$($n_x, n_y, n_z$ 为整数)。
- 在 k 空间中,每一个量子态占据的体积为 $(\frac{2\pi}{L})^3 = \frac{8\pi^3}{V}$。
- 考虑泡利不相容原理,每个允许的 $\mathbf{k}$ 状态可以容纳自旋相反的两个电子。因此,k 空间单位体积内的量子态数为:$\frac{2}{8\pi^3 / V} = \frac{V}{4\pi^3}$。
- 结论:k 空间中的量子态是均匀分布的。
2. 从 k 空间到能量 E 空间的转换
为了求 $g(E)$,我们需要计算能量在 $E$ 到 $E+dE$ 之间的量子态数 $dZ$。
- 在 k 空间中,能量为 $E$ 和 $E+dE$ 的等能面之间构成一个球壳(假设导带底位于 $k=0$ 且等能面为球面)。
- 球壳在 k 空间的体积为:$d\Omega_k = 4\pi k^2 dk$。
- 对应的量子态总数为:$dZ = \frac{V}{4\pi^3} \cdot 4\pi k^2 dk = \frac{V}{\pi^2} k^2 dk$。
3. 结合能带关系求解
对于导带底附近的电子,其能量与波矢的关系为有效质量近似:
$$E(k) = E_c + \frac{\hbar^2 k^2}{2m_n^*}$$
从中解出 $k$ 和 $dk$:
$$k = \frac{\sqrt{2m_n^*(E - E_c)}}{\hbar}$$
$$dE = \frac{\hbar^2 k}{m_n^*} dk \implies dk = \frac{m_n^*}{\hbar^2 k} dE$$
将 $k$ 和 $dk$ 代入 $dZ$ 的表达式,并将 $\hbar = h / 2\pi$ 代入,即可得到单位体积、单位能量间隔的状态密度 $g_c(E) = \frac{1}{V} \frac{dZ}{dE}$。
具体结果与状态密度有效质量
状态密度分布
1. 导带底附近状态密度
对于等能面为球面(如 GaAs)的情况,推导结果为:
$$g_c(E) = \frac{4\pi (2m_{dn}^*)^{3/2}}{h^3} \sqrt{E - E_c}, \quad (E > E_c)$$
对于等能面为旋转椭球面(如 Si、Ge,极值不在 $k=0$)的情况,引入电子状态密度有效质量 $m_{dn}$ 替代上式中的 $m_n^*$:
$$m_{dn} = s^{2/3}(m_t^2 m_l)^{1/3}$$
其中 $s$ 为导带底等价极值点数,$m_t$、$m_l$ 分别为横向和纵向有效质量。
2. 价带顶附近状态密度
由于价带顶存在重空穴带和轻空穴带的简并,需要将两者的状态密度相加。引入空穴状态密度有效质量 $m_{dp}$:
$$m_{dp} = \left[(m_{ph})^{3/2} + (m_{pl})^{3/2}\right]^{2/3}$$
价带顶的状态密度表示为:
$$g_v(E) = \frac{4\pi (2m_{dp}^*)^{3/2}}{h^3} \sqrt{E_v - E}, \quad (E < E_v)$$
3. 常见半导体参数表
| 材料 | $m_t$ | $m_l$ | $s$ | $m_{dn}$ |
|---|---|---|---|---|
| Si | $0.19m_0$ | $0.98m_0$ | 6 | $1.08m_0$ |
| Ge | $0.082m_0$ | $1.64m_0$ | 4 | $0.56m_0$ |
| GaAs | $0.067m_0$ | $0.067m_0$ | 1 | $0.067m_0$ |
| 材料 | $m_{pl}$ | $m_{ph}$ | $m_{dp}$ |
|---|---|---|---|
| Si | $0.16m_0$ | $0.53m_0$ | $0.59m_0$ |
| Ge | $0.044m_0$ | $0.36m_0$ | $0.37m_0$ |
| GaAs | $0.082m_0$ | $0.45m_0$ | $0.47m_0$ |
费米能级和载流子的统计分布
费米-狄拉克分布函数
热平衡状态下,服从泡利不相容原理的电子在各个能量状态上的统计分布概率由费米-狄拉克函数决定:
$$f(E) = \frac{1}{1 + \exp\left(\dfrac{E - E_F}{k_0 T}\right)}$$
表示能量为 $E$ 的量子态被电子占据的概率。
费米狄拉克分布
费米能级 $E_F$ 的物理意义与性质:
- 热力学上,$E_F$ 是系统的化学势(恒温恒压下增加一个电子引起的吉布斯自由能变化)。
- $E_F$ 标志着电子填充能级的水平。当 $E = E_F$ 时,$f(E_F) = 1/2$。
- 热平衡时,整个半导体系统只有一个统一的费米能级。
- 绝对零度 ($T = 0 \text{K}$) 时,$f(E)$ 是一个阶跃函数:$E < E_F$ 的态被电子完全填满,$E > E_F$ 的态完全空着。
- 当温度升高时,分布在 $E_F$ 附近约 $\pm 2k_0T$ 的范围内从 1 平滑过渡到 0。
玻尔兹曼近似(非简并情况)
当能级能量远高于费米能级,即 $E - E_F \gg k_0T$ 时,分布函数分母中的指数项远大于1,此时1可以忽略不计:
$$f(E) \approx \exp\left(-\frac{E - E_F}{k_0 T}\right)$$
这称为玻尔兹曼分布。适用此近似的半导体称为非简并半导体(即费米能级位于禁带中,且距离导带底和价带顶均大于 $2k_0T \sim 3k_0T$)。
空穴占据概率:
价带中某能级被空穴占据的概率等于该能级未被电子占据的概率:
$$f_p(E) = 1 - f(E) = \frac{1}{1 + \exp\left(\dfrac{E_F - E}{k_0 T}\right)}$$
当 $E_F - E \gg k_0T$ 时,同样可简化为空穴的玻尔兹曼分布:$f_p(E) \approx \exp\left(-\frac{E_F - E}{k_0 T}\right)$。
非简并半导体的载流子浓度推导
1. 导带电子浓度 $n_0$
电子浓度等于状态密度与占据概率的乘积在整个导带上的积分:
$$n_0 = \int_{E_c}^{\infty} g_c(E) f(E) dE$$
代入 $g_c(E)$ 和玻尔兹曼近似的 $f(E)$:
$$n_0 = \int_{E_c}^{\infty} \frac{4\pi (2m_{dn}^*)^{3/2}}{h^3} \sqrt{E - E_c} \exp\left(-\frac{E - E_F}{k_0 T}\right) dE$$
提取常数,并令 $x = \frac{E - E_c}{k_0 T}$,则 $dE = k_0 T dx$:
$$n_0 = \frac{4\pi (2m_{dn}^* k_0 T)^{3/2}}{h^3} \exp\left(-\frac{E_c - E_F}{k_0 T}\right) \int_0^{\infty} \sqrt{x} e^{-x} dx$$
利用伽马函数积分 $\int_0^{\infty} x^{1/2} e^{-x} dx = \frac{\sqrt{\pi}}{2}$,得到最终结果:
$$n_0 = N_c \exp\left(-\frac{E_c - E_F}{k_0 T}\right)$$
其中 $N_c = 2\left(\frac{2\pi m_{dn}^* k_0 T}{h^2}\right)^{3/2}$ 称为导带有效状态密度。
2. 价带空穴浓度 $p_0$
同理,积分 $p_0 = \int_{-\infty}^{E_v} g_v(E) f_p(E) dE$,可得:
$$p_0 = N_v \exp\left(-\frac{E_F - E_v}{k_0 T}\right)$$
其中 $N_v = 2\left(\frac{2\pi m_{dp}^* k_0 T}{h^2}\right)^{3/2}$ 称为价带有效状态密度。
3. 载流子浓度乘积(质量作用定律)
将 $n_0$ 与 $p_0$ 相乘:
$$n_0 p_0 = N_c N_v \exp\left(-\frac{E_c - E_v}{k_0 T}\right) = N_c N_v \exp\left(-\frac{E_g}{k_0 T}\right) = n_i^2$$
此乘积只与温度和材料的禁带宽度有关,与费米能级位置无关,与杂质掺杂浓度无关。该定律适用于所有热平衡下的非简并半导体。
本征半导体的载流子浓度
本征费米能级的推导
本征半导体未掺杂杂质,载流子全部来自于本征激发,产生电子-空穴对。因此其核心特征为电中性条件:
$$n_0 = p_0$$
将非简并载流子浓度公式代入上式:
$$N_c \exp\left(-\frac{E_c - E_i}{k_0 T}\right) = N_v \exp\left(-\frac{E_i - E_v}{k_0 T}\right)$$
(注:将本征情况下的费米能级记作 $E_i$)
两边取自然对数并重新排列,解出 $E_i$:
$$\frac{2E_i}{k_0 T} = \frac{E_c + E_v}{k_0 T} + \ln\left(\frac{N_v}{N_c}\right)$$
$$E_i = \frac{E_c + E_v}{2} + \frac{1}{2} k_0 T \ln\left(\frac{N_v}{N_c}\right)$$
代入 $N_c$ 和 $N_v$ 的表达式:
$$E_i = \frac{E_c + E_v}{2} + \frac{3}{4} k_0 T \ln\left(\frac{m_{dp}^*}{m_{dn}^*}\right)$$
结论:本征费米能级 $E_i$ 位于禁带中线附近。如果电子和空穴有效质量相等,则 $E_i$ 严格位于禁带中央。温度变化引起的 $E_i$ 偏移量很小。
本征载流子浓度
本征半导体载流子分布
因为 $n_i^2 = n_0 p_0$,本征载流子浓度为:
$$n_i = \sqrt{N_c N_v} \exp\left(-\frac{E_g}{2k_0 T}\right)$$
将其展开并提取温度相关项:
$$n_i = 2\left(\frac{2\pi k_0}{h^2}\right)^{3/2} (m_{dn}^* m_{dp}^*)^{3/4} T^{3/2} \exp\left(-\frac{E_g}{2k_0 T}\right)$$
可见,温度越高、$E_g$ 越小,则本征载流子浓度越大。指数项对 $n_i$ 的影响占据主导地位。
最高工作温度限制
半导体器件必须在其载流子主要由杂质电离提供(即杂质半导体特性)的温度范围内工作。若温度过高,本征激发产生的 $n_i$ 急剧增加,当 $n_i$ 超过掺杂浓度时,器件特性将失控。
工程上通常取 $n_i(T) < \frac{N_D}{10}$ 作为器件能正常工作的判据。
不同材料在 $N_D = 5 \times 10^{15} \text{cm}^{-3}$ 时的极限工作温度:
- Ge ($E_g = 0.67\text{eV}$): ~370 K
- Si ($E_g = 1.12\text{eV}$): ~520 K
- GaAs ($E_g = 1.428\text{eV}$): ~720 K
材料禁带越宽,其允许的最高工作温度越高,故 GaAs 更适合制作大功率、耐高温器件。
杂质半导体的载流子浓度
杂质能级上的载流子统计
杂质能级与能带中的状态不同。能带中每个能级可容纳自旋相反的两个电子,而施主能级只能容纳一个任意自旋方向的电子(或空置),这使得杂质能级的统计分布函数必须考虑自旋简并度(因子为1/2)。
施主能级被电子占据的概率 $f_D$:
$$f_D = \frac{1}{1 + \frac{1}{2}\exp\left(\dfrac{E_D - E_F}{k_0 T}\right)}$$
电离施主浓度 $N_D^+$(即失去电子的施主浓度):
$$N_D^+ = N_D(1 - f_D) = \frac{N_D}{1 + 2\exp\left(\dfrac{E_F - E_D}{k_0 T}\right)}$$
同理,受主能级被空穴占据的概率 $f_A$ 及电离受主浓度 $N_A^-$:
$$f_A = \frac{1}{1 + \frac{1}{2}\exp\left(\dfrac{E_F - E_A}{k_0 T}\right)}$$
$$N_A^- = \frac{N_A}{1 + 2\exp\left(\dfrac{E_A - E_F}{k_0 T}\right)}$$
n 型半导体载流子浓度推导
考虑只含有施主杂质(浓度为 $N_D$)的 n 型半导体。由电中性条件:
$$n_0 = N_D^+ + p_0$$
(即系统总负电荷等于总正电荷)
随着温度从绝对零度逐渐升高,载流子浓度和费米能级会经历不同的区域:
1. 低温弱电离区
n型非简并半导体载流子分布
温度很低时,本征激发可忽略 ($p_0 \approx 0$),且大部分施主未电离 ($n_0 \ll N_D$)。
此时电中性条件变为:$n_0 \approx N_D^+$。
代入非简并 $n_0$ 公式和近似的 $N_D^+$ 公式(假设 $E_F > E_D$,分母中指数项占优):
$$N_c \exp\left(-\frac{E_c - E_F}{k_0 T}\right) \approx \frac{N_D}{2\exp\left(\dfrac{E_F - E_D}{k_0 T}\right)}$$
两边整理,解出 $E_F$:
$$E_F = \frac{E_c + E_D}{2} + \frac{1}{2} k_0 T \ln\left(\frac{N_D}{2N_c}\right)$$
将 $E_F$ 代回 $n_0$ 表达式得到:
$$n_0 = \sqrt{\frac{N_c N_D}{2}} \exp\left(-\frac{\Delta E_D}{2k_0 T}\right)$$
其中 $\Delta E_D = E_c - E_D$ 为施主电离能。若实验测得 $\ln n_0$ 随 $1/T$ 的关系曲线,其斜率即为 $-\Delta E_D / 2k_0$,由此可测定电离能。
2. 饱和电离区(强电离区)
温度继续升高,施主杂质几乎全部电离,但此时本征激发仍然微弱 ($p_0$ 仍可忽略)。
此时:$N_D^+ \approx N_D$,且 $n_0 \approx N_D$。
因为 $n_0 = N_D$,代入 $n_0$ 的公式可求得费米能级:
$$N_D = N_c \exp\left(-\frac{E_c - E_F}{k_0 T}\right) \implies E_F = E_c - k_0 T \ln\left(\frac{N_c}{N_D}\right)$$
这是半导体器件最主要的工作温区。掺杂浓度 $N_D$ 越大,$E_F$ 越靠近导带底 $E_c$。
3. 强本征激发区
温度非常高时,本征激发的电子浓度远远超过施主浓度 ($n_i \gg N_D$)。
此时电中性条件退化为 $n_0 \approx p_0 \approx n_i$,半导体呈现本征特性,费米能级趋近于 $E_i$。
费米能级随温度变化曲线
p 型半导体情况
完全对称于 n 型半导体,在饱和电离区:
$$p_0 = N_A, \quad n_0 = \frac{n_i^2}{N_A}$$
$$E_F = E_v + k_0 T \ln\left(\frac{N_v}{N_A}\right)$$
一般情况下的载流子统计分布(补偿半导体)
实际的半导体单晶中往往同时存在施主和受主杂质,此时会发生补偿效应(施主提供的电子优先落入受主的空能级中抵消)。
普遍的电中性条件
在一般情况下,满足:
$$n_0 + N_A^- = p_0 + N_D^+$$
(导带电子 + 电离受主 = 价带空穴 + 电离施主)
补偿 n 型半导体($N_D > N_A$)的推导
在饱和电离区,假设所有杂质全部电离,即 $N_D^+ = N_D$,且 $N_A^- = N_A$。
电中性条件变为:
$$n_0 + N_A = p_0 + N_D \implies n_0 - p_0 = N_D - N_A$$
由质量作用定律 $p_0 = n_i^2 / n_0$,代入上式得到一元二次方程:
$$n_0 - \frac{n_i^2}{n_0} = N_D - N_A \implies n_0^2 - (N_D - N_A)n_0 - n_i^2 = 0$$
解该方程(取正根):
$$n_0 = \frac{N_D - N_A}{2} + \sqrt{\left(\frac{N_D - N_A}{2}\right)^2 + n_i^2}$$
由于在正常工作温度下,处于饱和电离区且未进入本征区,满足 $(N_D - N_A) \gg n_i$,因此可以近似:
$$n_0 \approx N_D - N_A, \quad p_0 \approx \frac{n_i^2}{N_D - N_A}$$
补偿效应使得有效掺杂浓度变为 $N_D - N_A$。
对于补偿 p 型半导体($N_A > N_D$),同理可得:
$$p_0 \approx N_A - N_D, \quad n_0 \approx \frac{n_i^2}{N_A - N_D}$$
费米能级位置规律总结
费米能级随温度变化曲线
随掺杂浓度的变化:
- 受主浓度 $N_A$ 升高,费米能级 $E_F$ 向下移动,靠近价带顶 $E_v$。
- 施主浓度 $N_D$ 升高,费米能级 $E_F$ 向上移动,靠近导带底 $E_c$。
随温度的变化:
- 无论 n 型还是 p 型,温度升高最终都会使本征激发占优,导致 $E_F$ 向本征费米能级 $E_i$(禁带中线)移动。
- 掺杂浓度越低,费米能级随温度变化向中线靠拢得越快;重掺杂可以使器件在更宽的温度范围内保持杂质导电的稳定特性。
少数载流子
在处于外加电场或温度梯度下时,少数载流子决定了许多关键的器件物理过程(如反向漏电流)。
- n 型半导体的少子(空穴):$p_0 = n_i^2 / N_D \propto \exp(-E_g / k_0 T)$。
- p 型半导体的少子(电子):$n_0 = n_i^2 / N_A \propto \exp(-E_g / k_0 T)$。
由于 $n_i^2$ 包含 $\exp(-E_g/k_0T)$ 项,少子浓度对温度的变化极其敏感,这是半导体器件存在高温极限的根本原因。
简并半导体
简并状态的产生
简并半导体载流子分布
当杂质掺杂浓度极高(通常超过 $10^{19} \text{cm}^{-3}$)时:
- 杂质能级分裂成杂质能带,并与导带底(或价带顶)重叠,导致有效禁带宽度变窄。
- 费米能级 $E_F$ 进入导带内部(n型)或价带内部(p型)。
- 此时 $E_c - E_F < 0$,不再满足 $E_c - E_F \gg k_0 T$ 的条件,玻尔兹曼近似失效。必须使用完整的费米-狄拉克分布进行计算,这类半导体被称为简并半导体。
简并半导体的载流子浓度推导
以 n 型简并半导体为例,回到最基础的积分公式:
$$n_0 = \int_{E_c}^{\infty} g_c(E) f(E) dE$$
代入 $g_c(E)$ 和未近似的 $f(E)$:
$$n_0 = \int_{E_c}^{\infty} \frac{4\pi(2m_{dn}^*)^{3/2}}{h^3} \sqrt{E - E_c} \frac{1}{1 + \exp\left(\dfrac{E - E_F}{k_0 T}\right)} dE$$
提取常数,并做变量代换。令积分变量 $x = \frac{E - E_c}{k_0 T}$,并定义参数 $\xi = \frac{E_F - E_c}{k_0 T}$:
$$n_0 = \frac{4\pi(2m_{dn}^* k_0 T)^{3/2}}{h^3} \int_0^{\infty} \frac{x^{1/2}}{1 + \exp(x - \xi)} dx$$
前面系数刚好是 $N_c \cdot \frac{2}{\sqrt{\pi}}$,后面部分被定义为费米-狄拉克积分 $F_{1/2}(\xi)$:
$$n_0 = N_c \frac{2}{\sqrt{\pi}} F_{1/2}(\xi)$$
其中费米积分 $F_{1/2}(\xi) = \int_0^{\infty} \frac{\sqrt{x}}{1 + e^{x - \xi}} dx$ 无法解析求解,需通过数值计算或查表获得。
(注:当非简并时 $\xi \ll -2$,$F_{1/2}(\xi) \approx \frac{\sqrt{\pi}}{2} e^{\xi}$,公式即可退化回 $n_0 = N_c \exp(\xi)$。)
简并化条件与临界浓度
以 $\xi = (E_F - E_c)/k_0 T$ 来划分简并程度:
- 非简并: $\xi < -2$ (即 $E_c - E_F > 2k_0T$)。
- 弱简并: $-2 \leq \xi < 0$ ($E_F$ 在导带底之下,但不满足远大于的条件)。
- 强简并: $\xi \geq 0$ ($E_F$ 已经进入导带内部)。
发生简并的临界浓度(以 $E_F = E_c$,即 $\xi = 0$ 为界):
$$N_D^* = n_0(\xi = 0) = N_c \frac{2}{\sqrt{\pi}} F_{1/2}(0)$$
查表可知 $F_{1/2}(0) \approx 0.678$ 或直接用近似级数展开求得 $N_D^* \approx 0.76 N_c$(注:不同教材近似值略有不同,部分取 $0.44 N_c$,本质都是与 $N_c$ 处于同一数量级)。当杂质浓度大于该临界值时,半导体即发生简并化。
简并半导体的物理特性
与非简并半导体相比,简并半导体具有以下特殊表现:
- 质量作用定律失效:由于载流子不再服从玻尔兹曼分布,乘积 $n_0 p_0$ 变得非常复杂,不再等于 $n_i^2$。
- 杂质电离不完全:费米能级进入能带后,高于(或低于)杂质能级的位置充满了载流子,大量杂质能级仍被电子占据,使得即使在室温下,杂质也无法做到100%电离。
- 禁带变窄效应:高掺杂导致杂质离子产生强大的局部电场,库仑排斥和交换相互作用使得电子波函数交叠,导带底向下延伸,价带顶向上延伸,宏观上表现为光学禁带宽度 $E_g$ 的减小。
- 电导率极高:因为载流子浓度不受温度的显著影响(一直处于类似于饱和电离的状态),呈现出类似金属的导电特性。通常用于制造隧道二极管、半导体激光器和集成电路中的欧姆接触区域。
小纸条
只有一张小纸条

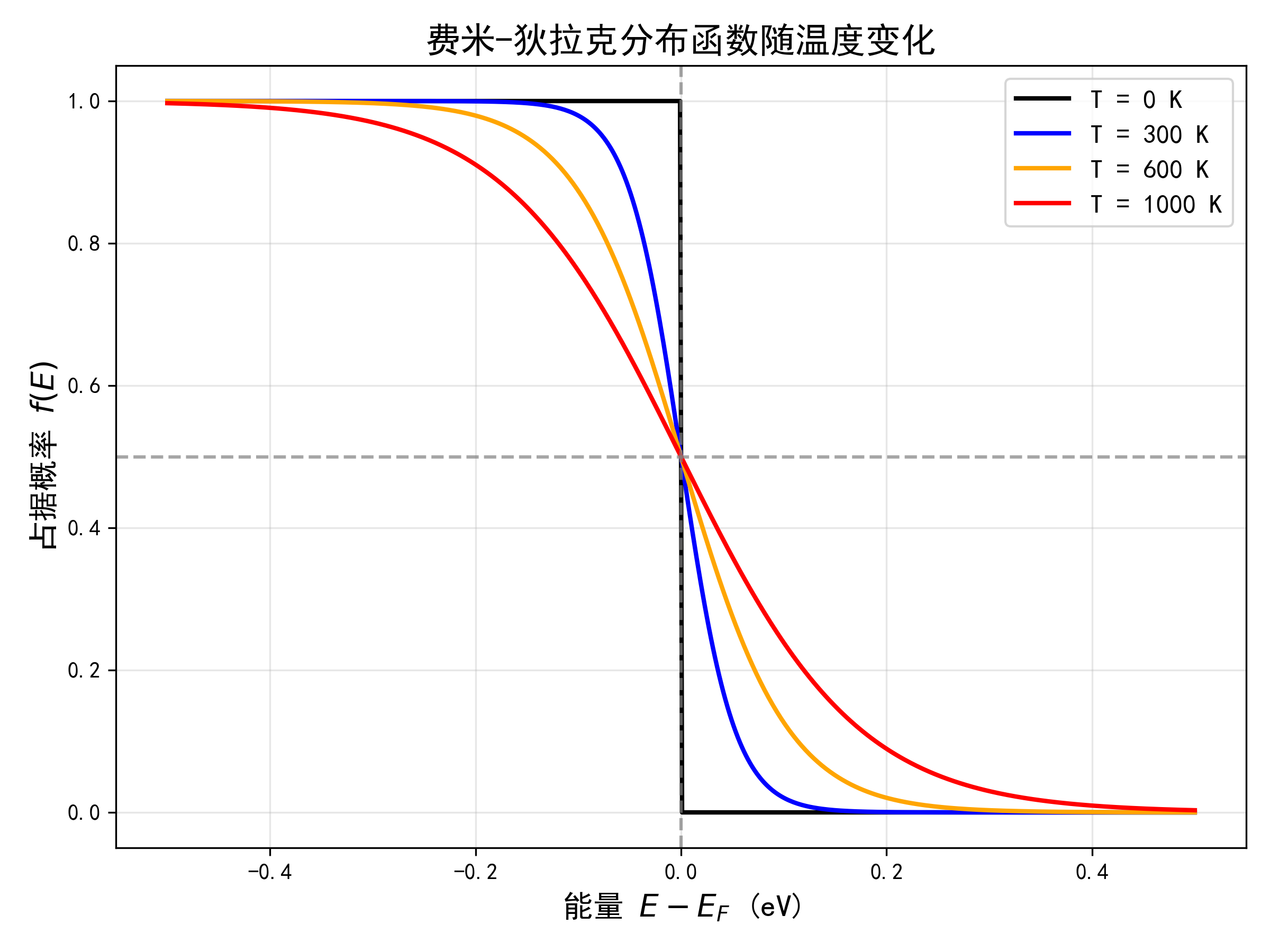
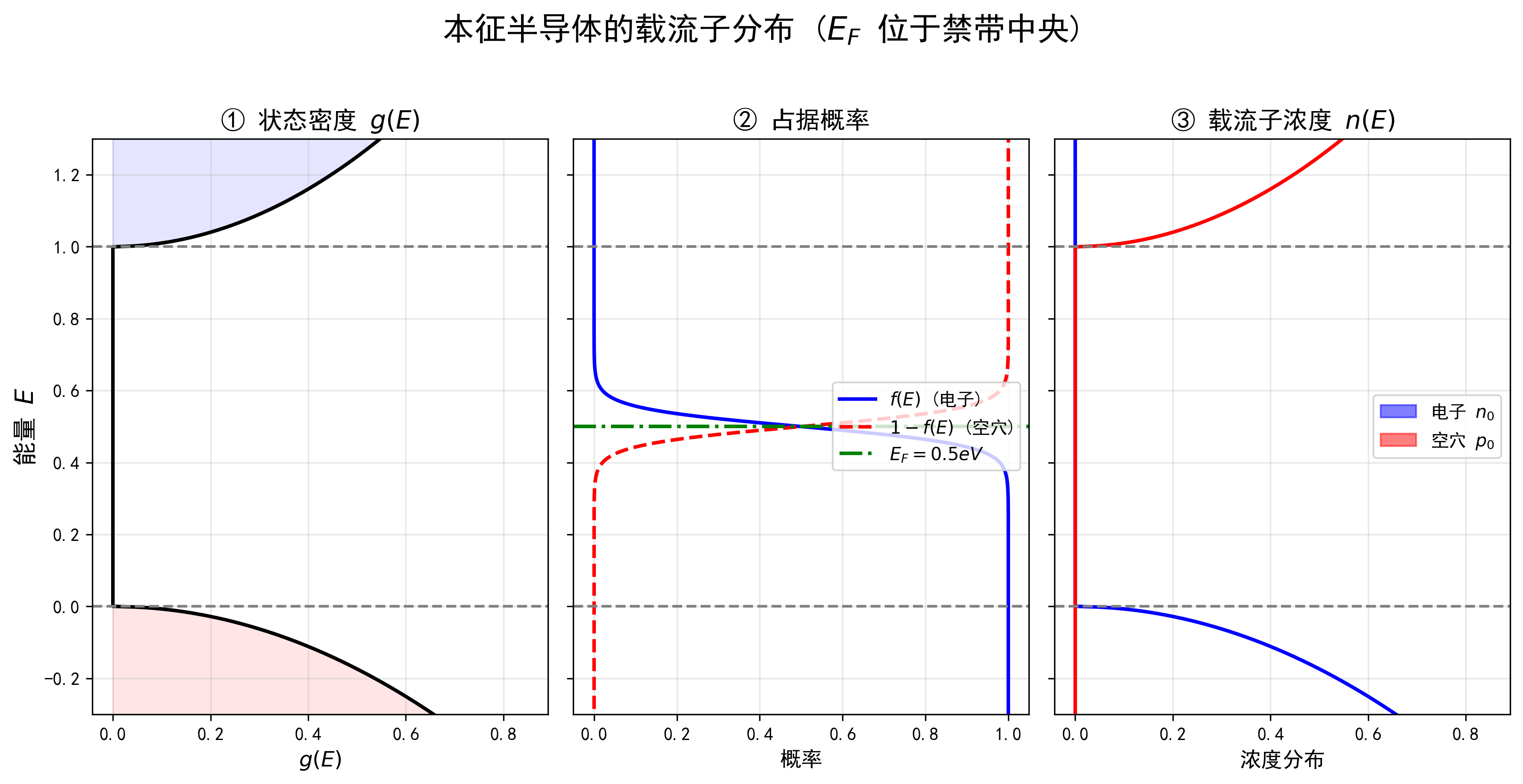
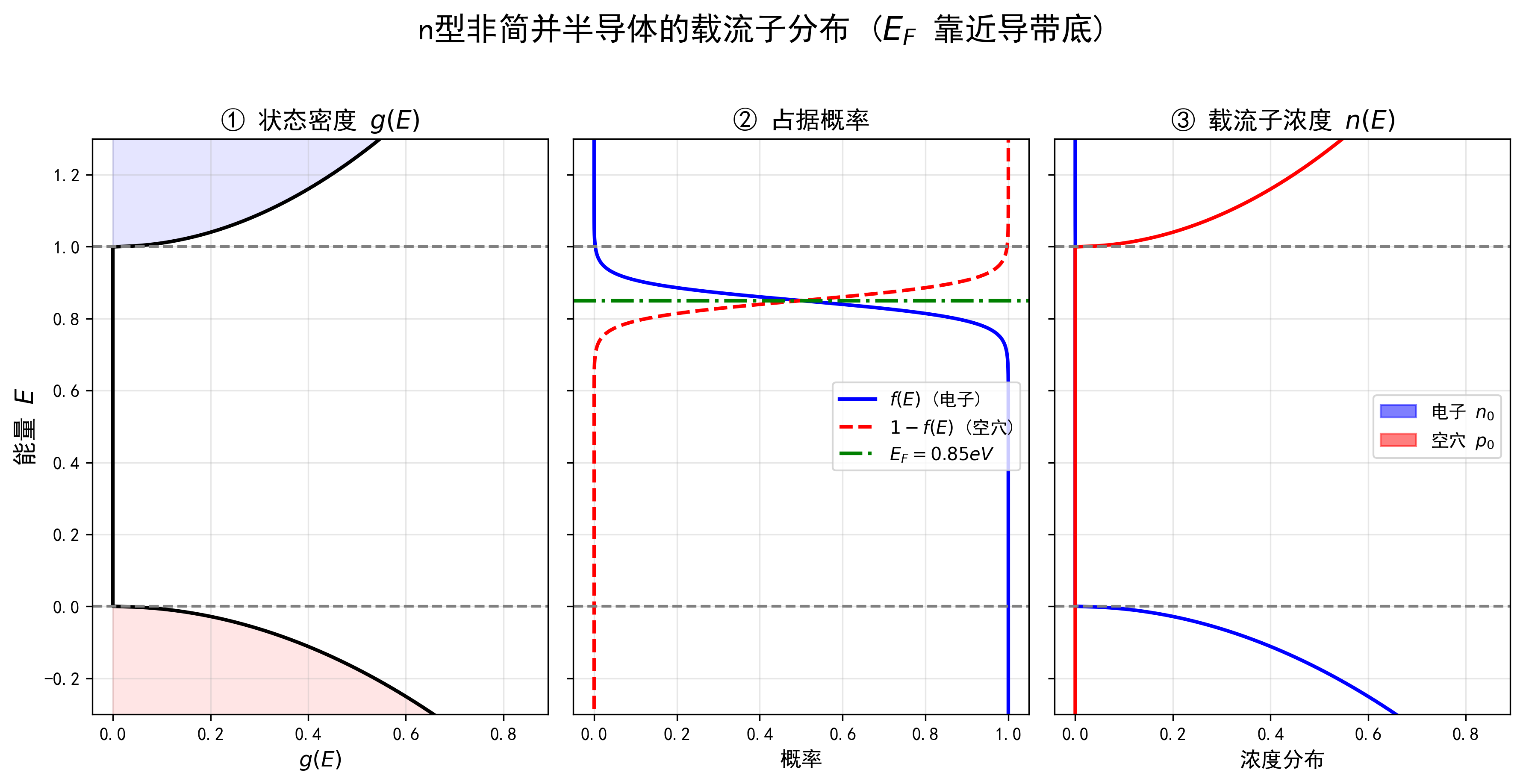
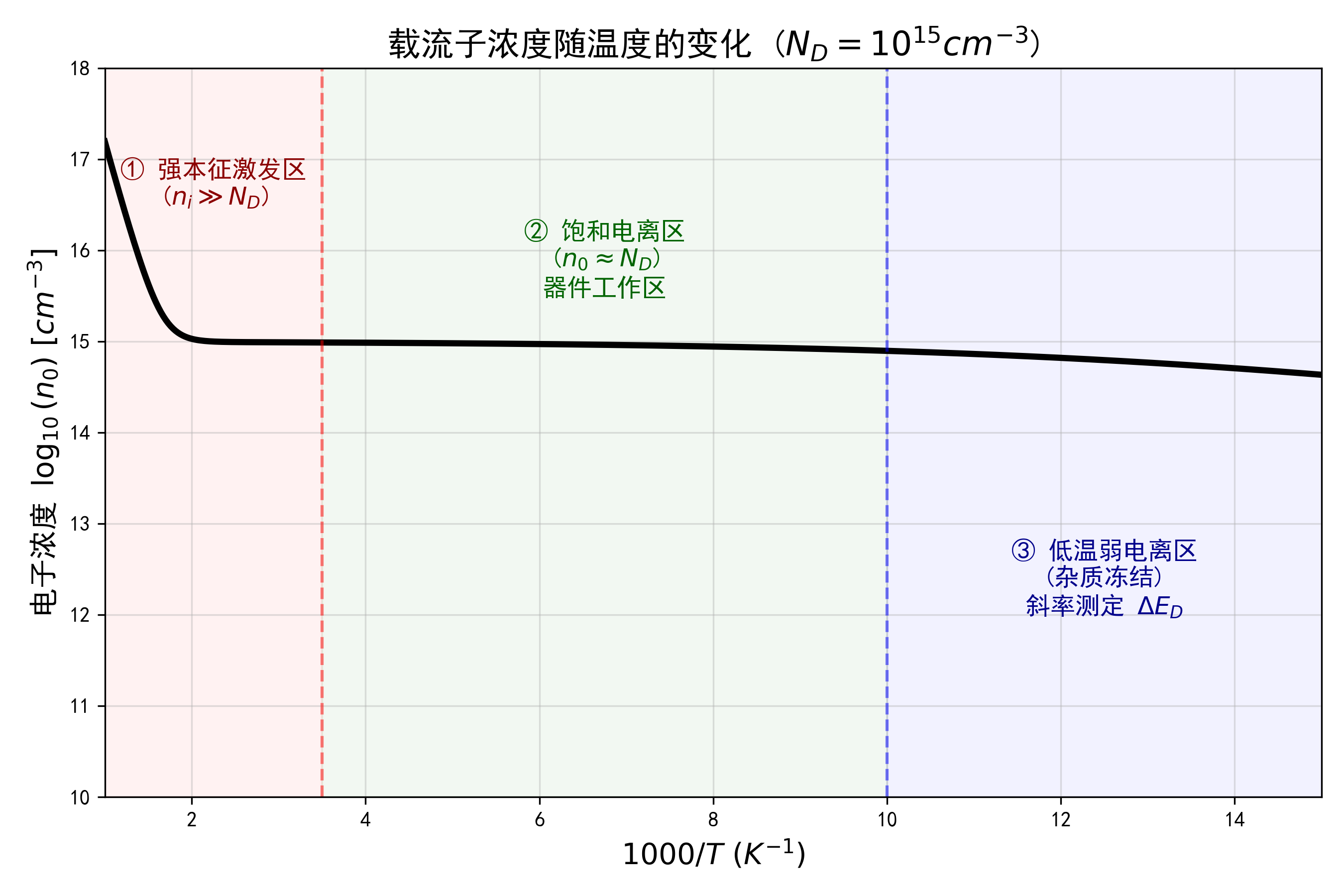

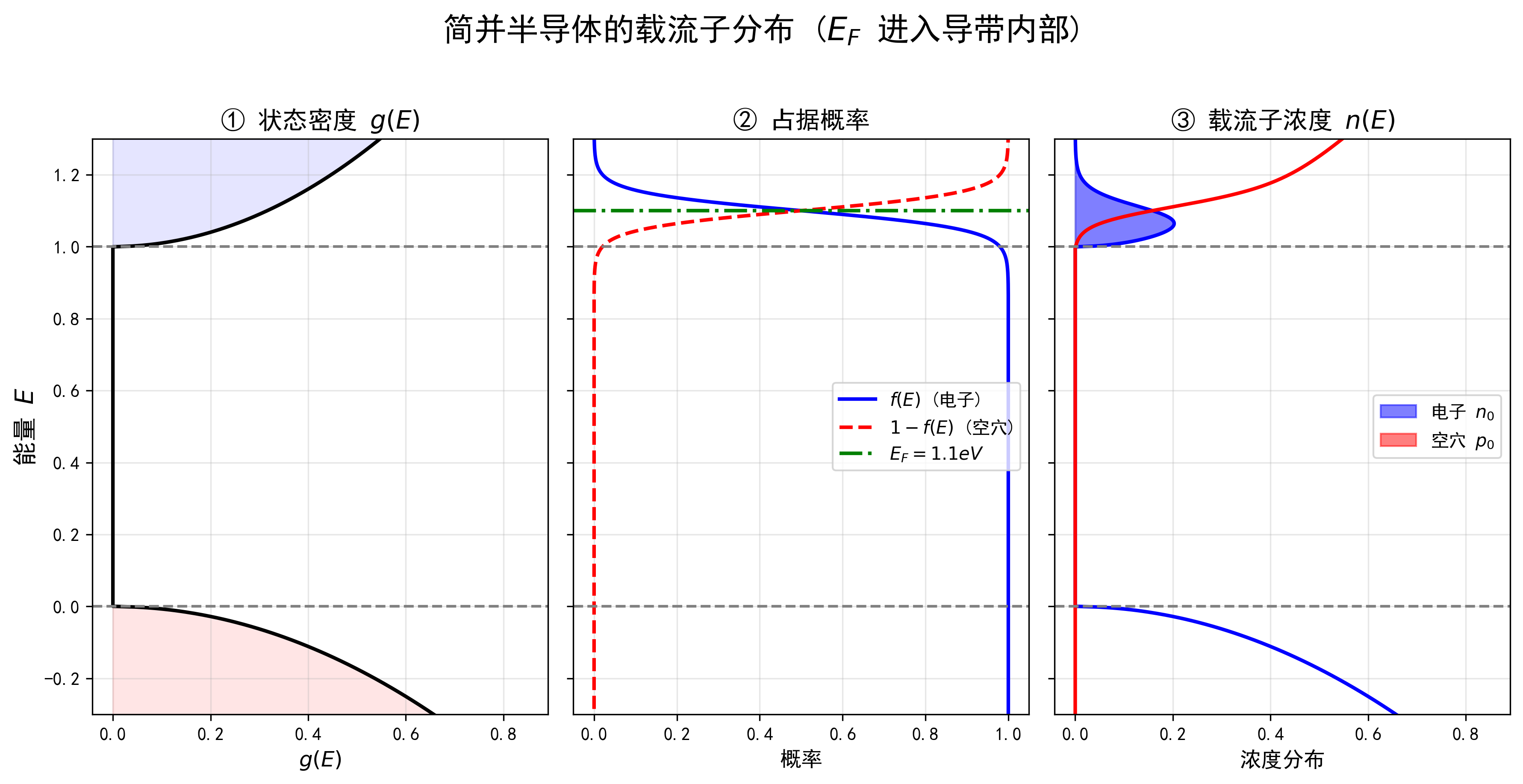
小德
本章以求解热平衡状态下半导体中电子与空穴的浓度为核心,首先通过量子态在k空间的均匀分布推导出能带状态密度 $g_c(E) \propto \sqrt{E - E_c}$,并结合描述微观粒子占据概率的费米-狄拉克分布函数 $f(E) = \left[1 + \exp\left(\frac{E - E_F}{k_0 T}\right)\right]^{-1}$,在非简并条件(即费米能级距能带边缘远大于 $k_0 T$)下运用玻尔兹曼近似,积分求得了非简并半导体导带电子与价带空穴的浓度基本公式 $n_0 = N_c \exp\left(-\frac{E_c - E_F}{k_0 T}\right)$ 与 $p_0 = N_v \exp\left(-\frac{E_F - E_v}{k_0 T}\right)$。在此基础上,理论推导不仅揭示了热平衡态下普遍适用的质量作用定律 $n_0 p_0 = n_i^2$,还系统分析了本征激发与杂质电离的竞争机制,明确了杂质半导体随温度升高依次经历的低温弱电离区、饱和电离区(即器件正常工作的温区,满足多子浓度 $n_0 \approx N_D$ 或 $p_0 \approx N_A$)及强本征激发区;最后,将理论外延至重掺杂的简并半导体体系,指出此时玻尔兹曼近似彻底失效、费米能级进入能带内部,必须借助完整的费米积分 $n_0 = N_c \frac{2}{\sqrt{\pi}} F_{1/2}(\xi)$ 来精确描述高浓度下载流子强烈的量子统计特性。